晶圆是指制作硅半导体电路所用的硅晶片,其原始材料是硅。高纯度的多晶硅溶解后掺入硅晶体晶种,然后慢慢拉出,形成圆柱形的单晶硅。硅晶棒在经过研磨,抛光,切片后,形成硅晶圆片,也就是晶圆。
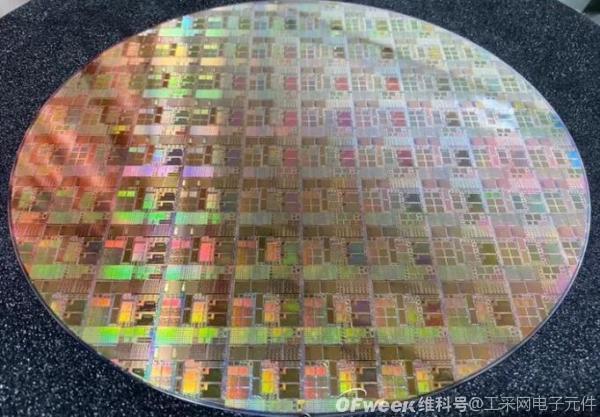
晶圆的主要加工方式为片加工和批加工,即同时加工1片或多片晶圆。随着半导体特征尺寸越来越小,加工及测量设备越来越先进,使得晶圆加工出现了新的数据特点。同时,特征尺寸的减小,使得晶圆加工时,空气中的颗粒数对晶圆加工后质量及可靠性的影响增大,而随着洁净的提高,颗粒数也出现了新的数据特点。
随着集成电路(Integrated circuit,IC)制造技术的不断发展,芯片特征尺寸越来越小,互连层数越来越多,晶圆直径也不断增大。要实现多层布线,晶圆表面必须具有极高的平整度、光滑度和洁净度,而化学机械抛光(Chemical mechanical polishing, CMP)是目前最有效的晶圆平坦化技术,它与光刻、刻蚀、离子注入、PVD/CVD一起被称为IC制造最核心的五大关键技术。

由工采网代理的台湾茂矽电子推出的IGBT晶圆 - P81MV022NL0013P是一款1200V、40A、FS工艺的6寸IGBT晶圆片;1200V壕沟和现场停止技术;低开关损耗;正温度系数;简单的平行技术。广泛应用在中等功率驱动器、1200V光伏、电焊机、工业缝纫机、伺服马达等等领域。
IGBT芯片经历了一系列的迭代过程从PT技术向NPT技术,再到现在FS技术的升级,使芯片变薄,降低了热阻,并提升了Tj。IEGT、CSTBT和MPT的引入;持续降低了Vce,并提高了功率密度;通过表面金属及钝化层优化,可满足车用的高可靠性要求。
FS生产工艺以轻掺杂N-区熔单晶硅作为起始材料,完成正面元胞制作之后再进行背面工艺。在硅片减薄之后,首先在硅片的背面注入磷,形成N+ buffer, 最后注入硼,形成P+ collector, 激活杂质后再淀积金属铝。
FS相对于NPT而言,背面增加了N型注入、硅片更薄,硅片在加工过程中的碎片率上升。更薄的N-区电阻小,使VCESAT更低;更薄N-层导通时存储的过剩载流子总量少,使关断时间及关断损耗减少。
台湾茂矽IGBT产品已经逐步进入新能源汽车、充电桩、电池管理以及光伏逆变等领域,并受到客户的青睐,ISWEEK工采网拥有一整套完整的解决方案,欢迎致电联系:133 9280 5792(微信同号)








